
產品介紹 Products Information
- 機器事業部
- 真空產品事業部
- 半導體事業部
- Hamamatsu Photonics
- LCOS-SLM
- UV Curing Product
- Microfocus X-Ray Source
- X-Ray Detector
- X-Ray Scintillator (CsI)
- Surface-Enhanced Raman Spectroscopy (SERS)
- X-Ray Flat Panel Sensor
- Excimer Lamp
- Lamp
- Pulsed Laser Diode
- PMT (Photomultiplier Tube)
- Avalanche Photodiode (APD)
- Optical components
- Camera
- mini-Spectrometer
- Electrostatic Removers
- MPPC (Multi-Pixel Photon Counter)
- Image Sensor
- Image Intensifiers (I.I.)
- Photodiode
- Mass spectrometry
- Flame Sensor (UVTRON®)
- Immunochromato-Reader
- Infrared Detector
- PSD (Position Sensitive Detector)
- LED
- Photo IC
- Pinhole inspection unit
- LCOS-SLM
- NJRC
- ST
- TAEJIN(HTC Korea)
- Hamamatsu Photonics
- 電子零件事業部
- 化學事業部
聯絡資訊
Contact
- 半導體IC產品
- 聯絡人: 劉小姐
- 電話: +886-2-8772-8910 分機 619
聯絡資訊
Contact
- 電子零件產品
- 聯絡人: 林小姐
- 電話: +886-2-8772-8910 分機618
聯絡資訊
Contact
- 真空相關產品
- 聯絡人: 王經理
- 電話: +886-2-8772-8910 分機161
聯絡資訊
Contact
- PCB機器
- 聯絡人: 王小姐
- 電話: +886-2-8772-8910 分機631
聯絡資訊
Contact
- 化學相關產品
- 聯絡人: 陳小姐
- 電話: +886-2-8772-8910 分機633
聯絡資訊
Contact
- 不確定品牌/型號
- 聯絡人: 陳小姐
- 電話: +886-2-8772-8910 分機633
4W 離子蝕刻系統
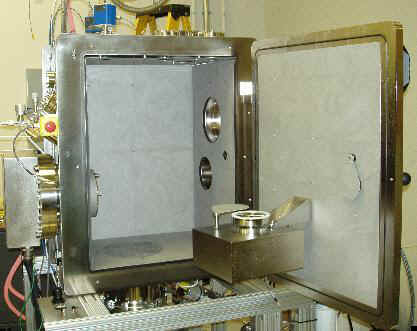
![]() +886-2-8772-8910
+886-2-8772-8910
4W 離子蝕刻系統介紹:
LIBE,LISE和LIME系列離子蝕刻系統設計靈活,性價比高、佔用空間小適合通用研究和生產應用。LIBE,LISE和LIME系列離子蝕刻系統以真空平臺為基礎採用兩種不同的離子源。
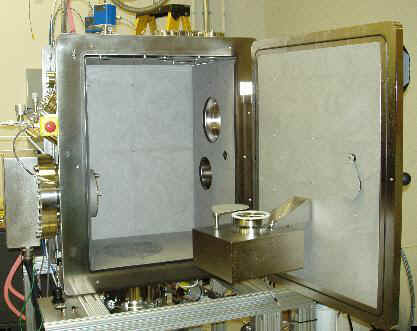
4W 離子蝕刻系統操作原理
利用具有準直特性之離子源,以類似噴砂的效果進行具有方向性的次微米薄膜表面轟擊,在欲處理面上形成所需要的圖形。
通入的氣體為惰性氣體時,如 Ar,則只進行物理性的離子轟擊;或是通入反應性氣體,如O2、NF3、SF6或其他化學氣體等,則會有化學反應的蝕刻效果。
.jpg)
.jpg)
4W 離子蝕刻系統應用:
離子蝕刻,離子清洗,等離子灰化,等離子體氧化,表面改性,活性腐蝕,離子束/等離子體化學氣相沉積
薄膜圖形化,線路化,磁性薄膜
自旋電子,MR Sensor
微機電元件,射頻元件,光學元件
超導體
4W 離子蝕刻系統特點:
20cm,12cm,8cm 考夫曼離子源
高產量低能耗的等離子源
直徑150mm工藝表面
脈衝直流偏壓
樣品平台可傾斜,旋轉,水冷,
操作簡單,佔用空間小
相對濕式蝕刻(wet etch),乾式離子蝕刻技術的優點
圖形線路化精準度佳
線路側蝕現象較少
製程重複性高
對任何材料都有效果
均勻性較佳
檔案下載
Copyright © Hakuto Taiwan Ltd. All Rights Reserved.


聯絡資訊
Contact
- 半導體IC產品
- 聯絡人: 劉小姐
- 電話: +886-2-8772-8910 分機 619
聯絡資訊
Contact
- 電子零件產品
- 聯絡人: 林小姐
- 電話: +886-2-8772-8910 分機618
聯絡資訊
Contact
- 真空相關產品
- 聯絡人: 王經理
- 電話: +886-2-8772-8910 分機161
聯絡資訊
Contact
- PCB機器
- 聯絡人: 王小姐
- 電話: +886-2-8772-8910 分機631
聯絡資訊
Contact
- 化學相關產品
- 聯絡人: 陳小姐
- 電話: +886-2-8772-8910 分機633
聯絡資訊
Contact
- 不確定品牌/型號
- 聯絡人: 陳小姐
- 電話: +886-2-8772-8910 分機633